Легирование методом термической диффузии примесей.
Условия возникновения p-n-перехода
В подавляющем большинстве случаев легирующая примесь вводится в монокристаллический кремний с целью изменения типа проводимости и образования p-n-перехода на определённой глубине. Изменение типа проводимости имеет место в случае, если максимальная концентрация введённой примеси превышает исходную концентрацию (Nисх). Образование p-n-перехода происходит на глубине Хn, где концентрация введённой примеси оказывается равной исходной.
Таким образом, основные характеристики диффузионных слоев:
- поверхностное сопротивление, или поверхностная концентрация
примеси;
- глубина залегания p − n -перехода или легированного слоя;
- распределение примеси в легированном слое.

Рис. 3. Принцип образования p-n-перехода.
При термической диффузии (рис. 3) максимальная концентрация примеси всегда на поверхности (N0) и монотонно убывает с глубиной.
Протекание процесса диффузии во времени отражает 2-е
уравнение диффузии: ![]()
На практике используются два варианта проведения процесса: диффузия из постоянного внешнего источника и диффузия из конечного поверхностного источника.
Диффузия из постоянного внешнего источника (одностадийный процесс)
В этом случае внешний (вне рабочей камеры) источник постоянно поставляет к поверхности пластин примесь в газообразном состоянии, причём её расход отрегулирован так, что на поверхности пластины поддерживается постоянная концентрация N0, хотя примесь при этом поступает вглубь кристалла. Процесс выполняют до тех пор, пока p-n-переход не окажется на заданной глубине.
При N0=const решение указанного уравнения приводит к функции:
![]()
 где
где ![]() – дополнение функции ошибок erfV (до
единицы), имеет табличное значение.
– дополнение функции ошибок erfV (до
единицы), имеет табличное значение.
Рис. 4. Распределение примеси при диффузии из постоянного внешнего источника
Распределение примеси для двух времен t1 < t2 показано на рис. 4. Поскольку в данном случае может быть создана и выдержана до конца процесса предельно высокая концентрация на поверхности кристалла, этот одностадийный процесс рекомендуется для областей n+ и p+ (эмиттерные области в биполярных транзисторах, истоки и стоки МДП-транзисторов). Естественно, что с течением времени p-n-переход углубляется.
Диффузия из конечного поверхностного источника
В этом случае поверхность кристалла содержит определённое количество примеси на единицу площади, и процесс сводится к перераспределению (разгонке) её по глубине до тех пор, пока p-n-переход не углубится на заданную величину Xn. Таким образом, количество примеси, введённое предварительно в поверхностный слой, или доза легирования Q [см–2] сохраняется постоянной до конца процесса разгонки.
При Q=const решение исходного уравнения приводит к функции:

где D и t – коэффициент диффузии и время процесса разгонки. При отсутствии внешнего источника примеси разгонка происходит при непрерывном уменьшении концентрации примеси на поверхности.
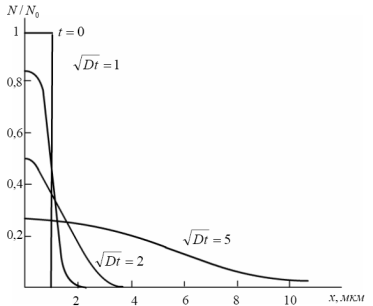
Рис. 5. Распределение примеси при диффузии из конечного поверхностного источника
Распределение примеси для различных значений времени разгонки показано на рис. 5. Из характера изменения профиля распределения примеси с течением времени следует, что концентрация примеси на поверхности постепенно убывает, p-n-переход углубляется, а доза легирования Q, характеризуемая площадью под кривой распределения, остаётся неизменной.
Необходимая доза легирования Q обеспечивается на первой стадии процесса (загонка примеси) с постоянным внешним источником примеси:
![]()
где D3 и t3 - коэффициент диффузии и время процесса загонки; N03-концентрация примеси, поддерживаемая на поверхности пластины в течение процесса загонки.
Двухстадийный процесс рекомендуется для областей с умеренной концентрацией примеси на поверхности и относительно глубоких (базовые области биполярных транзисторов, изолирующие "карманы" в КМДП-структурах). Двухстадийный процесс позволяет осуществлять контроль результатов после первой стадии и корректировать режим второй стадии.