Оптическая
литография, получение наноструктур. Фазосдвигающие маски. Многослойные резисты.
Использование и проблемы оптической литографии.
Оптическая
литография, получение наноструктур
Рассматривая
возможность применения обычного литографического процесса для получения
рисунков с размерами нанометрового масштаба необходимо определить критические
ступени, которыми в предлагаемой схеме являются процесс экспонирования и
травления.
Минимальный
размер рисунка, который может быть разрешен с помощью той или иной оптической
системы может быть оценен с использованием известной формулы
 =k1
=k1 /NA (5)
/NA (5)
где  - разрешение, k1 – константа зависящая от типа
использованного резиста, типа литографического процесса,
- разрешение, k1 – константа зависящая от типа
использованного резиста, типа литографического процесса,  -
длина волны света, NA – численная апертура оптической системы.
-
длина волны света, NA – численная апертура оптической системы.
Формула
показывает, что уменьшение длины волны и (или) увеличение численной апертуры
позволяет реализовать более высокое разрешение. Оптическая литография всегда
развивалась по этому пути. Для производства микросхем с 350 нм рисунками
использовалась 360 нм дуговая ртутная лампа (i линия). Дальнейшее увеличение
степени интеграции микросхем привело к переходу литографических систем в
область так называемого глубокого ультрафиолета (deep UV). 250 нм транзисторы
рисуются с использованием 248 нм KrF эксимерного лазера, 180 нм литография
оперирует с излучением 198 нм ArF эксимерного лазера. 118 -120 нм литография
ориентирована на использование 157 нм F2 лазера.
Увеличение
числовой апертуры имеет определенные ограничения, связанные в первую очередь с
уменьшением глубины фокуса (DOF)
В
обычной фотографии мы сталкиваемся с проблемой малой глубины фокуса, когда
изображения предмета и фона не находятся в фокусе одновременно. С
литографической точки зрения необходимо иметь четкое изображение как рисунка на
вершине слоя резиста, так и в глубине. Применение систем с высокой апертурой и
короткой длиной волны снижает глубину фокуса до недопустимых пределов даже для
субмикронного разрешения и становится серьезной проблемой для получения
приборов наноэлектроники.
Для
толстых резистов (по сравнению с длиной волны используемого света) достижение
необходимой глубины фокуса становится существенной проблемой.
Таким образом,
существует ряд физических и технических проблем затрудняющих прямое
использование существующего литографического процесса для создания структур
наноразмерного масштаба. Однако применение более сложных оптических систем и
процессов позволяет надеяться на то, что возможности традиционной литографии далеко
не исчерпаны. Остановимся на некоторых разрабатываемых в этом направлении
процессах подробнее.
Фазосдвигающие маски.
При
экспонировании близкорасположенных линий световые лучи имеют приблизительно
одинаковые фазы. Это приводит к тому, что в области между линиями наблюдается
интерференция хвостов световых потоков экспонирующих различные линии. Это
приводит к резкому снижению разрешения при работе в режиме близком к
дифракционному пределу. Ситуацию можно исправить, если обеспечить
экспонирование соседних линий лучами с противоположными фазами. Сдвиг фаз
обеспечивается применением специальных фазосдвигающих покрытий при изготовлении
фотошаблонов. Схема соответствующего процесса приведена на рис. 7. В
некоторых случаях использование интерференции сдвинутых по фазе лучей
используется для экспонирования отдельных линий, размер которых существенно
меньше длины волны используемого света.
Более
простым способом исключения интерференционных эффектов является экспонирование
с применением внеосевого освещения. В этом случае фазовый сдвиг обеспечивается
тем, что угол падения света на резист выбирается таким образом, чтобы соседние
линии освещались лучами с противоположными фазами.
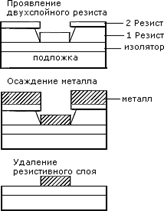
Рис.
10. «Lift –off» процесс, основанный на применении двухслойного резиста.
Существует
много вариантов использования двухслойного резиста. Один из них получил
название «lift-off» процесс и часто используется для получения металлических
линий нанометрового масштаба. Он приведен на рис. 10.
Применение сложных оптических систем, новых источников экспонирования (F2),
многослойных резистов позволяет рассчитывать, что существующие литографические
процессы, основанные на применении глубокого ультрафиолета, позволят
перешагнуть 100 нм рубеж. Существующее состояние может быть продемонстрировано
рис. 11.
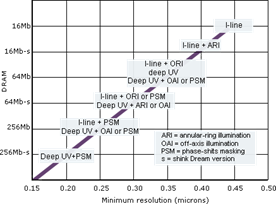
Рис.
11. Тенденции в развитии литографического процесса с субмикронным разрешением.
Для получения структур с разрешением ниже 100 нм становится
обоснованным использование принципильно новых способов экспонирования. Принимая
во внимание необходимость разработки высокопроизводительных литографических
систем можно выделить следующие 4 основные направления: предельный или
экстремальный ультрафиолет, электронная проекционная литография (SCALPEL),
рентгеновская литография, ионная литография.
Использование
и проблемы оптической литографии
Основные проблемы, стоящие перед разработчиками устройств
экспонирования, связаны с совмещением шаблонов последовательных уровней и
производительностью оборудования.
Поставщики резистов разрабатывают системы резистов с
повышенной фоточувствительностью и прочностью, способные противостоять
воздействию окружающей среды при плазменном травлении, применяемом в
современном технологическом процессе литографии. В научных и промышленных
лабораториях создаются системы многочисленных резистов, использование которых
может привести к повышению разрешения процесса оптической литографии до 0,5
мкм.
Эффекты близости при
литографии
а,)  б)
б) 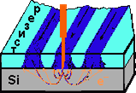
Рис.12.
Эффекты близости при литографии
Эффекты близости проявляются как
искажение получаемого на подложке изображения вследствие упругого и неупругого
рассеяния электронов на подложке. Электроны, рассеянные на атомах подложки,
проникают в прилежащие к лучу области резиста, производя его дополнительное
экспонирование (рис. 12 а), вызывая тем самым размытие изображения.
Различают внутренние и внешние
эффекты близости. Внутренние эффекты обусловлены рассеянием электронов,
формирующего изображение непосредственно в данной области, а внешние - рассеянием
электронов, формирующих изображение в соседних областях (рис. 12 б).
Для устранения эффекта близости
используется оптическая корректировка близости, которая продемонстрирована на
рис. 13.

Рис. 13. Оптическая корректировка
близости.
Разрешение
и профили краев элементов при субтрактивном переносе рисунка
Разрешение,
достигаемое в результате процесса травления, является критерием качества
переноса рисунка и определяется двумя параметрами. Первый из них - смещение,
равное разности горизонтальных размеров рисунка травления df и
рисунка маски dm (рис. 14). Допуск является мерой статического
распределения величин смещения, которая характеризует однородность травления в
горизонтальной плоскости.
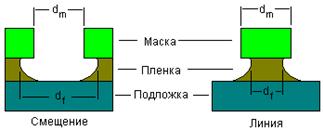
Рис. 14. Боковой подтрав пленки под маску на границе маска-пленка.
Процесс травления с нулевым смещением обеспечивает
формирование вертикального профиля края элемента, совпадающего с краем маски (рис.
14). В этом случае травления в горизонтальном направлении не происходит и
рисунок переносится с идеальной точностью, что соответствует экстремальной
ситуации идеально анизотропного травления. При равенстве вертикальной и
горизонтальной скоростей травления или, выражаясь более точно, когда скорость
травления не зависит от направления, к концу процесса формируется профиль края,
имеющий контур четверти окружности (рис. 15). В этом случае, т.е. при
изотропном травлении, смещение равно удвоенной толщине пленки, подвергавшейся
травлению.
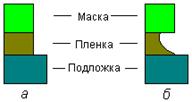
Рис. 15. Идеальные профили травления для: а - полностью анизотропного (Af=1)
и
б - изотропного (Af=0) травления при отсутствии подтрава
маски.
Любой профиль края элемента, формируемый к концу травления,
который соответствует ситуации, промежуточной между теми, что показаны на рис. 14,
образуется вследствие анизотропии скорости травления. Степень анизотропии можно
определить как Af=1-vl/vv, где vl и
vv - горизонтальная и вертикальная скорости травления
соответственно. Это же уравнение можно выразить и через параметры элемента,
формируемого к концу процесса травления: Af=1-|B|/2hf,
где B - смещение, а hf - толщина пленки. Таким образом, для
изотропного травления Af>0, а при 1>=Af>0
реализуется анизотропное травление.
Отражение от поверхности стоячей волны продемонстрировано
на следующем рисунке. Для устранения эффекта используются антиотражающие
покрытия подложки, в состав резиста добавляются специальные компоненты, сушка
проявленного резиста, используют источник света с несколькими длинами волн.
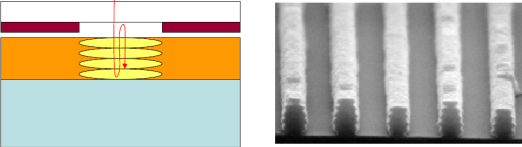
Рис.
16. Отражение стоячей волны от поверхности дна канавки.
Эффект
поверхностной топографии продемонстрирован на рис. 17. Для его устранения
пластина планаризуется. На рис. 18 показана результирующая структуры,
позволяющая решить указанные проблемы.
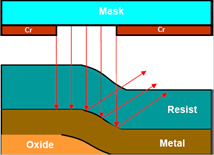
Рис.
17. Эффект поверхностной топографии.
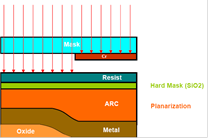
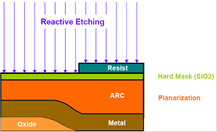
Рис.
18. Поверхность покрыта антиотражающим покрытием с планаризацией, твердой
маской и фоторезистом.
![]() =k1
=k1![]() /NA (5)
/NA (5)![]() - разрешение, k1 – константа зависящая от типа
использованного резиста, типа литографического процесса,
- разрешение, k1 – константа зависящая от типа
использованного резиста, типа литографического процесса, ![]() -
длина волны света, NA – численная апертура оптической системы.
-
длина волны света, NA – численная апертура оптической системы. 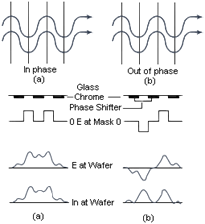
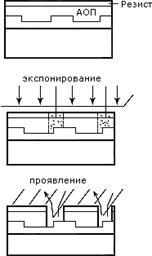

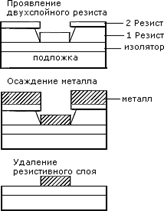
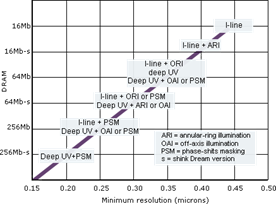
 б)
б)