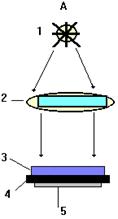
Рис. 4. Контактная печать: 1- источник света 2- оптическая система 3- шаблон 4- фоторезист 5- кремниевая пластина
Оптическая литография. Контактная, бесконтактная, проекционная печать. Литография с экстремальным ультрафиолетом.
Оптическая литография
Основными методами оптического экспонирования являются контактный, бесконтактный и проекционный.
Контактная печать. При контактной печати (рис. 4) пластина кремния, покрытая резистом, находится в непосредственном физическом контакте со стеклянным фотошаблоном. Пластина установлена на вакуумном держателе, который поднимает ее до тех пор, пока пластина и шаблон не придут в соприкосновение друг с другом. Прикладываемое при этом усилие составляет несколько килограммов. Для того чтобы провести совмещение топологического рисунка фотошаблона с предыдущим, вытравленным в кремнии топологическим рисунком, шаблон и пластину разводят на 25 мкм, а пару объективов с сильным увеличением помещают сзади шаблона для одновременного наблюдения рисунков шаблона и пластины из двух точек. Объективы принадлежат микроскопу с разведенным полем зрения, так что правый глаз видит точку на правой стороне шаблона и пластины, а левый - точку слева. Шаблон и пластину совмещают механическим перемещением и вращением вакуумного держателя до совпадения топологических рисунков шаблона и пластины.
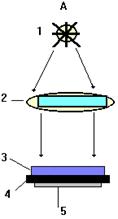
Рис. 4. Контактная печать: 1- источник света 2- оптическая система 3- шаблон 4- фоторезист 5- кремниевая пластина
В этом положении пластина приводится в соприкосновение с шаблоном и проводится еще одна проверка на точность совмещения. При экспонировании микроскоп автоматически отводится и коллимированный луч ультрафиолетового (УФ) облучения освещает весь шаблон в течение определенного времени экспонирования. Интенсивность экспонирования на поверхность пластины, умноженная на время экспонирования, дает энергию экспонирования или дозу облучения, получаемого резистом.
Разрешение при контактной литографии. Вследствие тесного контакта между резистом и шаблоном при контактной печати достигаются очень высокие значения разрешения. В пленке позитивного резиста толщиной 0,5 мкм достаточно легко можно воспроизвести элементы схемы размером 1 мкм.
Проблемы, возникающие при контактной печати, связаны с наличием загрязнений на поверхности кремниевой пластины. Кремниевая пылинка на пластине может привести к повреждению поверхности шаблона в момент его соприкосновения с пластиной. Поврежденный участок шаблона затем воспроизводится как дефектный топологический рисунок на всех других пластинах, при экспонировании которых использован этот шаблон. Каждая пластина добавляет свои собственные повреждения поверхности шаблона.
Если при изготовлении ИС не обеспечивается необходимая чистота процесса и окружающей среды, то лишь несколько кристаллов ИС не будут иметь дефектов. Для обеспечения высокого выхода годных кристаллов СБИС плотность дефектов (число дефектов на 1 см2) должна быть меньше 1 для каждого процесса литографического переноса.
Метод бесконтактного экспонирования (рис. 5) схож с методом контактной печати, за исключением того, что во время экспонирования между пластиной и шаблоном поддерживается небольшой зазор шириной 10-25 мкм. Этот зазор уменьшает (но не устраняет) возможность повреждения поверхности шаблона.
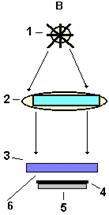
Рис. 5. Бесконтактная печать: 1- источник света; 2- оптическая система; 3- шаблон; 4- фоторезист; 5- кремниевая пластина; 6-зазор
При отсутствии физического контакта между шаблоном и пластиной перенос изображения осуществляется в дифракционной области Френеля, разрешение в которой пропорционально квадратному корню из произведения l*g, гдеl - длина волны экспонирующего излучения, g - ширина зазора между шаблоном и пластиной. При бесконтактной печати величина разрешения составляет 2-4 мкм.
Третий метод экспонирования - проекционная печать (рис. 6) позволяет полностью исключить повреждения поверхности шаблона. Изображение топологического рисунка шаблона проецируется на покрытую резистом пластинку, которая расположена на расстоянии нескольких сантиметров от шаблона. Для достижения высокого разрешения отображается только небольшая часть рисунка шаблона. Это небольшая отражаемая область сканируется или перемещается по поверхности пластины. В сканирующих проекционных устройствах печати шаблон и пластина синхронно перемещаются. С помощью этого метода достигается разрешение порядка 1,5 мкм ширины линий и расстояния между ними.
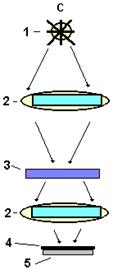
Рис. 6. Проекционная печать: 1- источник света, 2- оптическая система, 3- шаблон, 4- фоторезист, 5- кремниевая пластина
Проекционные устройства печати, в которых изображение на шаблоне перемещается над поверхностью пластины, называют системами с непосредственным перемещением по пластине или фотоштампами. При использовании этих устройств печати шаблон содержит топологию одного кристалла большого размера или нескольких кристаллов малых размеров, которые увеличены до десяти раз. Изображение этой топологии или структуры уменьшается и проецируется на поверхность пластины. После экспонирования одного элемента кристалла пластина сдвигается или перемещается на столике с интерферометрическим управлением по осям XY к следующему элементу одного кристалла, и процесс повторяется. С помощью уменьшающих проекционных фотоштампов можно получить разрешение ~1 мкм.
В большинстве современных проекционных систем печати оптические элементы являются настолько совершенными, что их характеристики точности отображения ограничены дифракционными эффектами, а не аберрацией линз. Эти устройства печати называют системами с дифракционным ограничением.
Литография с экстремальным ультрафиолетом
EUVL является обычной
оптической литографией, но с использованием излучения с длиной волны 11 - 14 нм
и отражательными оптикой и фотошаблонами. Источниками излучения в EUVL на
первом этапе развития подобных систем служило синхротронное излучение. Однако
позже был разработан малогабаритный источник предельного ультрафиолета, принцип
работы которого основан на использовании излучения из лазерной плазмы.
Излучение стандартного Nd:YAG лазера (1063 нм длина волны, 40 Вт мощность, 100
Гц частота, 5 нс длительность) фокусируется на импульсной газовой струе Xe
кластеров. Образующаяся лазерная плазма содержит широкую спектральную полосу
предельного ультрафиолета с ![]() ~10-25нм. Оптическая система
содержит набор зеркал между источником света и маской. Набор зеркал между
маской и подложкой с резистивным обеспечивает уменьшение размера изображения в
4 раза. Схема установки приведена на рис. 22. Все отражательные оптические
системы должны быть асферическими с размером неоднородностей ~10 Å. Эти
зеркала представляют собой сложные пленочные покрытия: от 40 до 80 двухслойных
пленок с толщиной каждого слоя ~
~10-25нм. Оптическая система
содержит набор зеркал между источником света и маской. Набор зеркал между
маской и подложкой с резистивным обеспечивает уменьшение размера изображения в
4 раза. Схема установки приведена на рис. 22. Все отражательные оптические
системы должны быть асферическими с размером неоднородностей ~10 Å. Эти
зеркала представляют собой сложные пленочные покрытия: от 40 до 80 двухслойных
пленок с толщиной каждого слоя ~ ![]() /4. Такое же сложное
строение имеет маска для EUV литографии, которая схематично представлена на
рис. 22.
/4. Такое же сложное
строение имеет маска для EUV литографии, которая схематично представлена на
рис. 22.

Рис. 22. Схема EUV литографии.
Подобный
литографический процесс позволяет рисовать линии с разрешением до 50 нм. Однако
большой проблемой подобных систем является малое поле зрения оптической схемы,
что не позволяем экспонировать всю поверхность кремниевой подложки. Подобные
системы, как впрочем, и все другие с малой величиной ![]() , требует
применения системы сканирования изображения маски по поверхности подложки.
, требует
применения системы сканирования изображения маски по поверхности подложки.
Если принять во внимание двадцатикратное снижение длины волны (от 248 до 20 нм), что позволит снизить значение численной апертуры и увеличить тем самым глубину фокуса и поле зрения оптических схем, то переход к EUV литографии позволил перейти 100 нм рубеж, оставаясь в рамках традиционной фотолитографии. Однако сложная зеркальная оптика и дорогостоящая технология изготовления фотошаблонов делает такой подход исключительно дорогостоящим и оставляет место для разработки литографических процессов основанных на иных физических принципах.
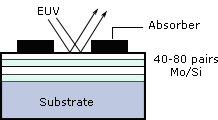
Рис. 23. Схема маски для EUV литографии.